合作客戶/
拜耳公司 |
同濟(jì)大學(xué) |
聯(lián)合大學(xué) |
美國(guó)保潔 |
美國(guó)強(qiáng)生 |
瑞士羅氏 |
相關(guān)新聞Info
-
> 魚(yú)缸水面產(chǎn)生油膜的主要原因
> 常見(jiàn)物質(zhì)的表面張力狀況
> 咪唑類離子液體對(duì)不同煤塵潤(rùn)濕性能的影響規(guī)律(下)
> NaOL、HZ組合捕收劑對(duì)鋰輝石礦物浮選效果、表面張力影響(三)
> 水成膜泡沫滅火劑之氟碳表面活性劑YM-316復(fù)配性能及表面張力測(cè)定(下)
> 雙內(nèi)凹結(jié)構(gòu)表面可實(shí)現(xiàn)對(duì)低表面張力液體的穩(wěn)固超排斥
> 鋰電池隔膜粘接劑組合物稀釋液表面張力測(cè)試及影響
> 最大拉桿法的基本原理、實(shí)驗(yàn)步驟、影響因素及其在測(cè)定溶液表面張力中的應(yīng)用
> 表面張力儀試驗(yàn)原理和方法解析
> ?基于液體表面張力的貼附力理論模型及實(shí)驗(yàn)驗(yàn)證
推薦新聞Info
-
> 不同礦漿濃度、粒度、伴生礦物、捕收劑和起泡劑對(duì)礦漿表面張力的影響(三)
> 不同礦漿濃度、粒度、伴生礦物、捕收劑和起泡劑對(duì)礦漿表面張力的影響(二)
> 不同礦漿濃度、粒度、伴生礦物、捕收劑和起泡劑對(duì)礦漿表面張力的影響(一)
> 長(zhǎng)慶油田隴東地區(qū)的CQZP-1助排劑表/界面張力測(cè)量及現(xiàn)場(chǎng)應(yīng)用(三)
> 長(zhǎng)慶油田隴東地區(qū)的CQZP-1助排劑表/界面張力測(cè)量及現(xiàn)場(chǎng)應(yīng)用(二)
> 長(zhǎng)慶油田隴東地區(qū)的CQZP-1助排劑表/界面張力測(cè)量及現(xiàn)場(chǎng)應(yīng)用(一)
> 液膜斷裂點(diǎn)與電壓最大值在表面張力測(cè)量中的對(duì)比研究(二)
> 液膜斷裂點(diǎn)與電壓最大值在表面張力測(cè)量中的對(duì)比研究(一)
> ?表面張力與表面張力系數(shù)測(cè)量:概念、方法與科學(xué)意義
> 微重力下二極對(duì)非均勻旋轉(zhuǎn)磁場(chǎng)控制半浮區(qū)液橋表面張力對(duì)流的數(shù)值研究(下)
電鍍液表面張力、接觸角、流速以及壓強(qiáng)等因素對(duì)硅通孔浸潤(rùn)過(guò)程的影響(一)
來(lái)源:《復(fù)旦學(xué)報(bào)(自然科學(xué)版)》 瀏覽 482 次 發(fā)布時(shí)間:2025-11-25
摘要:使用Fluent流場(chǎng)仿真軟件模擬了電鍍液對(duì)硅通孔(TSV)的浸潤(rùn)過(guò)程,討論了TSV深寬比、電鍍液流速、電鍍液表面張力、接觸角以及壓強(qiáng)等因素對(duì)TSV浸潤(rùn)過(guò)程的影響。通過(guò)對(duì)比仿真尋找出能在電鍍之前使電鍍液完全浸潤(rùn)TSV所有表面的預(yù)潤(rùn)濕處理方法,以防止因潤(rùn)濕不徹底在TSV底部形成氣泡而導(dǎo)致的有空洞電鍍填充。通過(guò)仿真發(fā)現(xiàn),電鍍液表面張力越小,電鍍液與待電鍍樣片表面的接觸角越小,浸潤(rùn)過(guò)程中電鍍液的流速越慢,浸潤(rùn)所處環(huán)境的壓強(qiáng)越低,則越有利于電鍍液對(duì)TSV的浸潤(rùn);且流速為0.002 m/s時(shí)即可對(duì)深寬比低于或等于130μm:30μm的TSV實(shí)現(xiàn)完全浸潤(rùn);浸潤(rùn)環(huán)境壓強(qiáng)低于3000 Pa時(shí)即可在流速為0.05 m/s時(shí)對(duì)深寬比為150μm:50μm的TSV基本實(shí)現(xiàn)完全浸潤(rùn)。當(dāng)TSV結(jié)構(gòu)的深寬比大于2的時(shí)候,沒(méi)有經(jīng)過(guò)預(yù)潤(rùn)濕而直接放入電鍍液的TSV結(jié)構(gòu)很難實(shí)現(xiàn)無(wú)空洞電鍍填充。
相比于傳統(tǒng)的片上系統(tǒng)(SoC)和系統(tǒng)級(jí)封裝(SiP)方法,在器件性能、互連密度、異質(zhì)集成化以及制造成本方面,三維疊層封裝(3D-IC)有很多的潛在優(yōu)勢(shì)。其中,實(shí)現(xiàn)了芯片與芯片之間最短互連的銅填充硅通孔(Through Silicon Via,TSV)技術(shù)是三維硅基封裝工藝的核心。為了能夠得到更高密度更好功能的封裝,對(duì)小直徑高深寬比TSV的需要變得越來(lái)越迫切。已有很多研究致力于TSV填充這一領(lǐng)域,電鍍銅填充TSV易于操作并且成本較低。使用這種方法實(shí)現(xiàn)高質(zhì)量TSV填充的標(biāo)志是無(wú)空洞填充、最小的表面銅覆蓋沉積量和相對(duì)較短的電鍍時(shí)間。其中,完成TSV無(wú)空洞快速填充的一個(gè)重要因素是在電鍍之前,實(shí)現(xiàn)電鍍液對(duì)TSV整個(gè)表面的充分潤(rùn)濕。目前,對(duì)于電鍍填充TSV的研究主要集中在電鍍過(guò)程中的優(yōu)化,如添加劑的使用、電流密度的控制等,有關(guān)TSV浸潤(rùn)條件以及相關(guān)影響因素的研究報(bào)道尚不多見(jiàn)。而TSV的充分潤(rùn)濕是實(shí)現(xiàn)高質(zhì)量TSV填充的前提,因此,本文的目的是通過(guò)模擬仿真電鍍液對(duì)TSV的潤(rùn)濕過(guò)程,尋找有效的方法使電鍍液能夠浸潤(rùn)TSV所有表面,尤其是高深寬比TSV的底部表面,確保實(shí)現(xiàn)無(wú)空洞電鍍填充。影響浸潤(rùn)程度的因素主要有:電鍍液的表面張力和接觸角,浸潤(rùn)過(guò)程中電鍍液的流速,浸潤(rùn)TSV所處環(huán)境的壓強(qiáng),TSV的深寬比,及TSV的形狀等。
本文主要針對(duì)上述前四個(gè)因素,用Fluent軟件進(jìn)行了仿真模擬,探討一種可實(shí)現(xiàn)并易于操作的浸潤(rùn)方法。
1 Fluent軟件的建模
按照實(shí)際電鍍液及樣片的情況,在流體仿真軟件中進(jìn)行建模。主要分為2個(gè)部分:前處理軟件Gambit中對(duì)平面模型的建立,F(xiàn)luent中對(duì)流場(chǎng)進(jìn)行具體解算。本文截取TSV軸對(duì)稱結(jié)構(gòu)的中心軸截面,建立二維分析模型,直接反應(yīng)實(shí)際TSV的浸潤(rùn)過(guò)程。同時(shí),基于對(duì)比實(shí)驗(yàn)考慮,忽略電鍍液組分與被浸潤(rùn)表面化學(xué)反應(yīng)造成的界面影響,并直接采用與電鍍液物理性質(zhì)基本相同的水作為液相組分。氣相組分中采用理想不可壓氣體假設(shè)模擬正常大氣壓下的操作環(huán)境。建立的Fluent分析模型如圖1所示。其中較小的矩形塊代表TSV,4~8代表被潤(rùn)濕表面。初始情況下,所有被模擬區(qū)域?yàn)闅庀鄥^(qū)域,之后液相從邊界3以特定流速進(jìn)入(除流速討論單元,其余均設(shè)置為0.05 m/s),逐步潤(rùn)濕全部或局部表面,直至從邊界1流出。具體設(shè)置為邊界1為壓力出口,2為對(duì)稱邊界,3為速度人口,4、5、6、7、8均為壁面邊界條件。表面張力和接觸角均采用實(shí)際測(cè)量值0.06 N/m,64°;重力加速度為9.81 m/s2,方向?yàn)樨Q直向下。

圖1說(shuō)明:1為壓力出口邊界,2為對(duì)稱邊界,3為速度人口,4~8均為壁面邊界條件。
2 TSV深寬比的影響
深寬比為150μm:75μm和150μm:50μm的TSV浸潤(rùn)仿真結(jié)果分別如圖2的(a)(b)所示,前者可以完全浸潤(rùn),后者在TSV底部形成氣泡。模擬結(jié)果表明如果不進(jìn)行充分潤(rùn)濕,深寬比大于2:1的TSV就會(huì)因不能完整浸潤(rùn)而在靠近TSV底部的位置形成部分表面緊貼TSV側(cè)壁的大氣泡,且該氣泡在之后的電鍍過(guò)程中難以排出,導(dǎo)致電鍍液無(wú)法接觸到TSV底部附近的位置,進(jìn)而形成較大空洞。
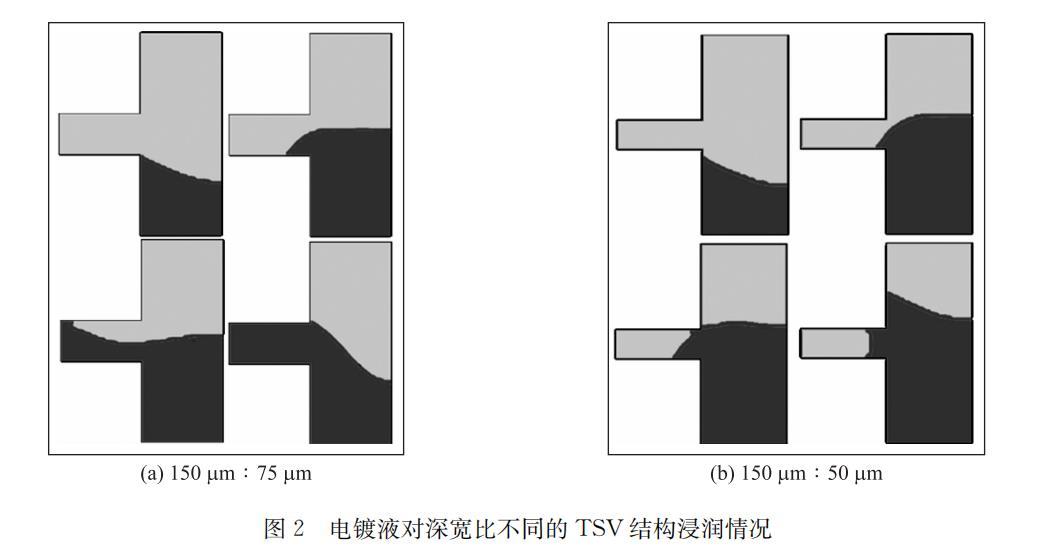
按照同樣設(shè)置仿真了深寬比為130μm:30μm和120μm:20μm的情況,結(jié)果均為不可完全浸潤(rùn)。










